-
E-Mail-Adresse
info@phenom-china.com
-
Telefon
18516656178
-
Adresse
No. 88 Shenbin Road, Hongqiao Town, Minhang District, Shanghai, Libao Square, Hongqiao, Shanghai, T5, Zimmer 705
Reconstruktionswissenschaftliche Instrumente (Shanghai) Co., Ltd.
AFM-SEM Synchronous Link-Technologie (Universal Edition)
- Modell
- Natur des Herstellers
- Hersteller
- Produktkategorie
- Ursprungsort
AFM-SEM Synchronous Link-Technologie (Universal Edition)
Produktbeschreibung
Das revolutionäre Atomkraftmikroskop (AFM) ermöglicht eine nahtlose Integration mit dem Scan-Elektronenmikroskop (SEM) und eröffnet neue Möglichkeiten für in situ assoziierte Mikroskope.
Durch das optimierte Design ist das LiteScope AFM kompatibel mit Symer, TESCAN、 SEM-Systeme und Zubehör von Mainmarken wie ZEISS, Hitachi, JEOL sowie Elektroskopen anderer Marken können maßgeschneidert angepasst werden.
Messmodus:
• Mechanische Eigenschaften: AFM, Energieverbreitung, Phasenbildgebung
• 电性能: C-AFM, KPFM, EFM und STM
• Magnetische Eigenschaften: MFM
• Elektromechanische Eigenschaften: PFM
• Spektrologie: F-Z
Kurve, I-V-Kurve
• Relevanzanalyse: CPEM
AFM-SEM Synchronous Link-Technologie (Universal Edition)
Praktische Merkmale
In-situ-Charakterisierung der Proben
Stellen Sie sicher, dass die Probenanalyse gleichzeitig, am gleichen Ort und unter den gleichen Bedingungen im SEM stattfindet und dass eine atomare Auflösung auch im Inneren des Flynanoskops erreicht wird
-
Genaue Positionierung der Interessengebiete
Die Kombination von SEM und AFM in situ gewährleistet eine Analyse zur gleichen Zeit, am gleichen Ort und unter den gleichen BedingungenMit SEM-Bildern können Sie die relative Position der Sonde und der Probe in Echtzeit beobachten, um die Sonde zu navigieren und genau zu positionieren
-
Erfüllen Sie komplexe Probenanalysenforderungen
Es bietet eine Vielzahl von Messmodi wie elektrische, magnetische, spektrale und andere und kann SEM- und EDS-Funktionen direkt an einem Ort kombiniert werden. Zugriff auf AFM- und SEM-Daten und nahtlose Verknüpfung
Kompositanalyse von Stahl und Legierungen
Zusammensetzungsanalyse von Doppelfasenstahl mit Atomkraftmikroskop, die Oberflächenformation (AFM), Eisen enthülltMagnetkategorienstruktur (MFM), Kornvergleich (SEM) und Oberflächenpotentialverreinigungen von OxygenkornenProbenkraftmikroanalyse.• Relevante multimodale Analyse enthüllt komplexe Eigenschaften• Genaue ROI-Positionierung mit Scanelektroskop, umfassende AFM-Analyse
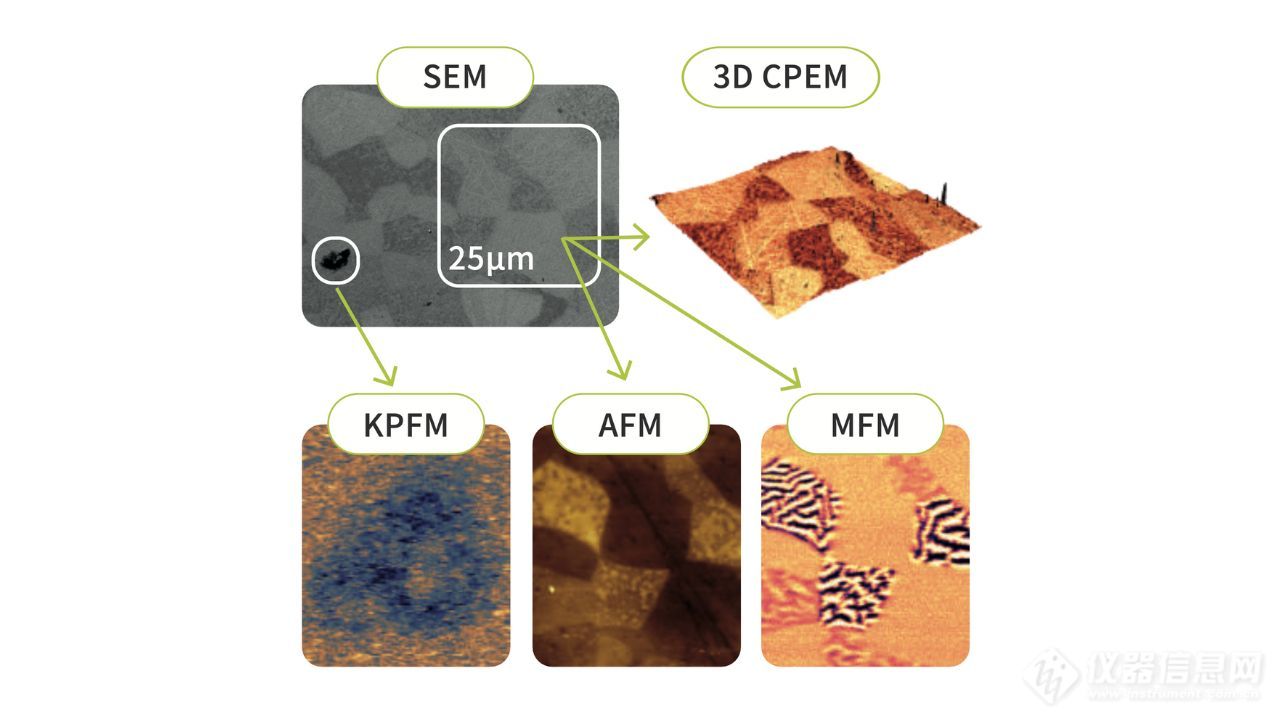
Onsite Charakterisierung der Batterie
Solid-State-Batterien (SSB) zeigen eine höhere Energiedichte, eine längere Lebensdauer und mehr als Lithium-Ionen-BatterienGute Sicherheit. Positivband aus Lithium-Nickel-Mangan-Kobaltoxid-Partikeln (NMC) in einer HandschuhkasseNach 200 Zyklen geöffnet, in situ geschnitten und mit AFM-in-SEM gemessen.
Probe zur Verfügung gestellt: Aleksandr Kondrakov, BELLA (DEU)
•Charakterisierung der lokalen Leitfähigkeit (C-AFM) am CAM-Querschnitt
•Empfindliche CAM vor Ort ohne Luftbelichtung
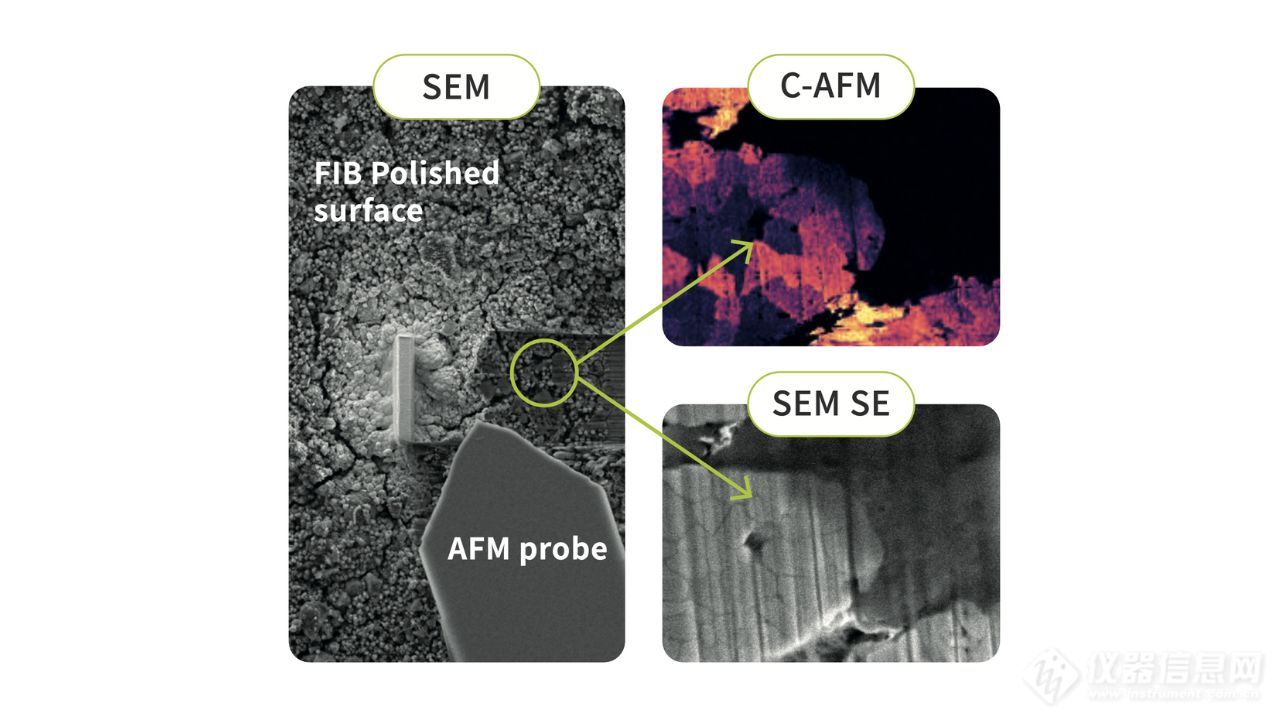
Ausgezeichnete Charakteristik von Nanodrähten
Der aufgehängte Spinnenseidennanodraht wurde aufgrund seiner mechanischen Eigenschaften durch ultrapräzise Positionierung von AFM untersuchtSpitze auf der hängenden Nano-Linie. Kraft-Entfernungsspektrometrie ermöglicht die Bestimmung der Elastizität und Plastizität der NanodrähteTransformation ist möglich.
Vorlage: Linnea Gustafsson, KTH (SWE).
• SEM: Echtzeit-Beobachtung der genauen Positionierung von AFM-Spitzen und Nanodahndeformationen
• Analyse von Eigenschaften wie Yang-Modul und Zugfestigkeit
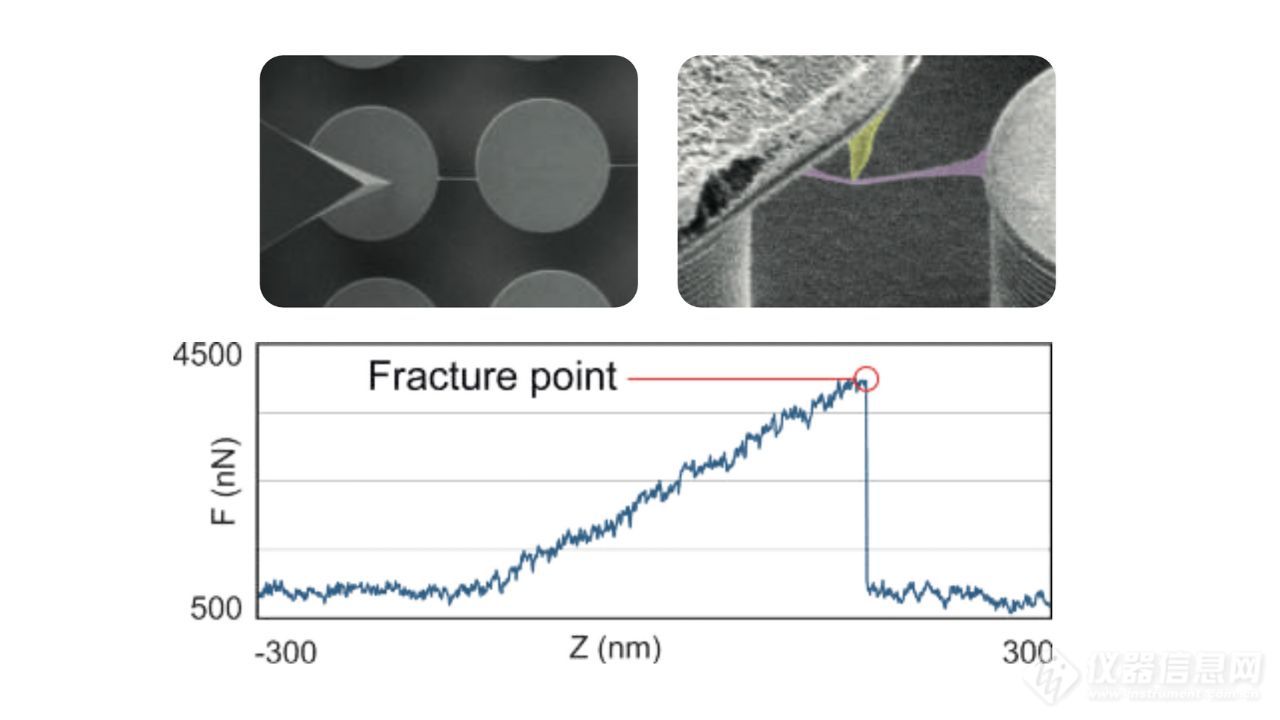
Zubehör auswählen
Nano-Preßmodul
Nano-Scratch-Modul ermöglicht die gleichzeitige Beobachtung von Proben mit einem ultrahohen Vielfachen-Scan-ElektronenmikroskopMikromechanische Versuche mit LiteScope in einer Subnanoscale-AuflösungAnalyse

NenoCase und Digitalkamera
Verwenden Sie LiteScope als unabhängiges AFM unter Umgebungsbedingungen oder in unterschiedlichen AtmosphärenPräzise Navigationssonde der Kamera.

Probe-Rotationsmodul
Für AFM-Analysen nach FIB geeignet. Außerdem erlaubt es, mehrere Proben gleichzeitig zu installierenMehrere Proben können mit geöffneter SEM-Kammer getestet werden.






